
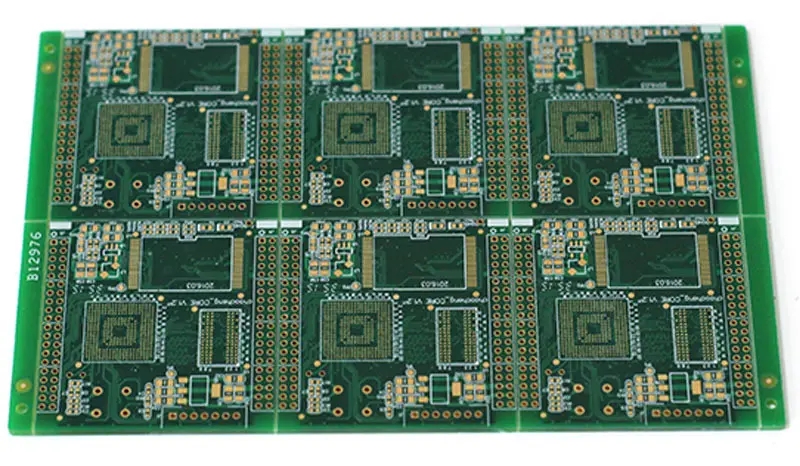
前言 如今,電子元件或 PWB 已經發生了很大變化。 1C封裝正從芯片尺寸的微型化向存儲器的三維安裝等方向發展,無源元件加速從片式元件向陶瓷覆層元件發展,并向嵌入式無源元件基板模塊或1C封裝方向發展。 他們開始轉向樹脂基基板,尤其是嵌入無源和有源元件基板。 硅(Si)芯片也有集成無源元件芯片,是適合1C封裝的嵌件基板,加速了嵌入式無源元件基板的發展。 本文介紹了嵌入式電子元件基板的技術趨勢。
提供元器件采購、PCB定制、選材等電子行業在線供應鏈解決方案,一站式滿足電子行業中小客戶的綜合需求。
電子元器件技術趨勢 隨著電子器件的小型化、高性能化、多功能化,IC封裝從單芯片的QFP、TCP發展到小型BGA、CSP,再到與同等尺寸的晶圓級CSP(d) 裸芯片。 此外,異構IC芯片的二維元件或三維安裝的封裝(MCP,多芯片封裝)或模塊化(MCM,多芯片模塊)的發展也在加速,基于IC芯片的系統LSI的發展也在加速 很活躍。 隨后,由于系統LSI設計的復雜性,長期從事PCB技術研究,在該刊發表多篇文章。
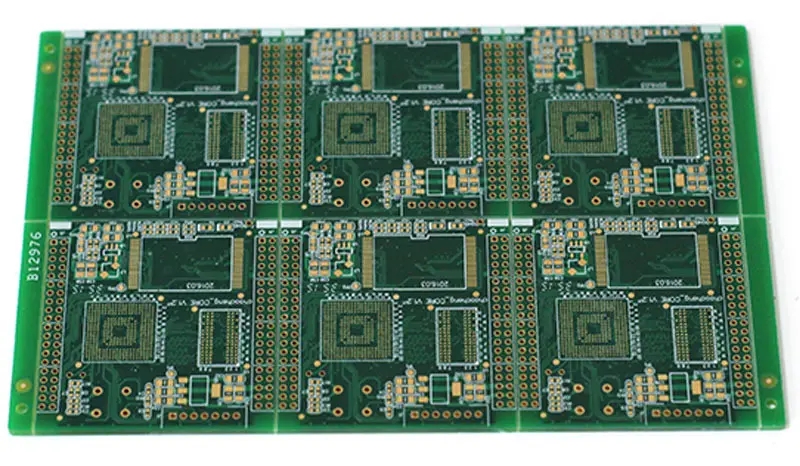
但由于陶瓷基板的脆性,不適用于大薄基板,僅限于特殊的小模塊或封裝。 此外,當基板受熱時,會發生百分之幾十的燒結收縮,這使得無法進行電氣檢查和嵌入高精度元件。 由于無法在燒結前后進行微調,因此很難形成誤差值為±1%的電阻。 因此,燒結收縮的波動程度是。
集成無源元件硅襯底趨勢 目前,陶瓷基襯底占據了無源元件集成和嵌入式襯底的絕大部分。 然而,最近又推出了采用半導體技術在硅襯底上形成LRC無源元件的集成無源器件(IPD)。 迄今為止,雖然還沒有集成無源元件的Si芯片,但Si芯片可以集成半導體1C中難以嵌入的大值無源元件。
陶瓷貼片元器件的方向性 由于微型貼片器件制造和安裝難度大,單個元器件的安裝效率或可操作性很差,采用相同或不同無源元器件的二維或三維復合器件數量較多 急劇增加。 近來,隨著手機數量的快速增加,搭載1C的模塊化趨勢正在加速。 但是,僅僅停留在電子機器的高性能、多功能、輕量化和小型化是不夠的。 數GHz至數十GHz頻段的高速、高頻、超小型便攜機的需求急劇增加。 傳統的SMT高密度安裝方式,采用基板與電子元器件分離制造、組合的方式,難以滿足提高性能、小型化、薄型化的要求。 因此,最近,無源元件和1C被嵌入到基板中,它可以縮短元件之間的連接長度,也可以抑制布線引起的LRC延遲、噪聲、發熱等問題。 將安裝方式從SMT轉移到SMT,不僅可以提高電子機的性能,實現電子機的輕量化和小型化,而且由于焊接位置的減少,提高了可靠性,降低了整體安裝成本。
陶瓷復合器件中嵌入被動元件的基板最早可以追溯到1970年代開發的低溫燒結玻璃陶瓷基板。 lt:800t~900t可嵌入以下燒結基板:燒結厚膜電阻器或厚膜電容器,于20世紀80年代中期實用化。 在這種結構中,LRC等器件印刷在玻璃陶瓷基板上,層壓后一次燒結。 但由于選擇范圍較小,一般只用于特殊用途。 80年代后半葉,鈦酸鋇(BaTiQ)或在鐵氧體等強電介質或強磁體芯片上印刷電極,疊層后燒結成無源復合元件的技術(c)。 由于具有不同燒結收縮率或熱膨脹系數的原始芯片的層壓和一次同時燒結,需要高度適應成分或燒結工藝的技術,電子元件制造商或陶瓷制造商為此做出了努力。
PCB制造商、PCB設計師和PCBA制造商將講解嵌入式電子元件基板的技術趨勢。
然后
聯系
電話熱線
13410863085Q Q

微信

- 郵箱











